
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Plasmaprosesser i CVD-operasjoner
1. Kammerrengjøring
Under prosessen med kjemisk dampavsetning (CVD) dannes avleiringer ikke bare på overflaten av skiven, men også på komponenter i prosesskammeret og dets vegger. Filmene som er avsatt på deler må fjernes regelmessig for å opprettholde stabile prosessforhold og forhindre partikkelforurensning av skivene. De fleste CVD-kamre bruker fluorbaserte kjemiske reaksjonsgasser for rengjøring.
I silisiumoksid CVD-kamre involverer plasmarensing vanligvis fluorkarbongasser som CF4, C2F6 og C3F8, som brytes ned i plasmaet og frigjør fluorradikaler. De kjemiske reaksjonene er representert som følger:
·e- + CF4 -> CF3 + F + e-
· e- + C2F6 -> C2F5 + F + e-
Fluoratomer, som er blant de mest reaktive radikalene, reagerer raskt med silisiumoksid for å danne gassformig SiF4, som lett kan evakueres fra kammeret:
·F + SiO2 -> SiF4 + O2 + andre flyktige biprodukter
Tungsten CVD-kamre bruker vanligvis SF6 og NF3 som kilder til fluor. Fluorradikaler reagerer med wolfram for å produsere flyktig wolframheksafluorid (WF6), som kan evakueres fra kammeret via vakuumpumper. Rengjøring av plasmakammeret kan avsluttes automatisk ved å overvåke emisjonsegenskapene til fluor i plasmaet, og unngå overdreven rensing av kammeret. Disse aspektene vil bli diskutert mer detaljert.
2. Gap Fyll
Når gapet mellom metalllinjer smalner til 0,25 µm med et sideforhold på 4:1, sliter de fleste CVD-avsetningsteknikker med å fylle hullene uten tomrom. High-Density Plasma CVD (HDP-CVD) er i stand til å fylle så smale hull uten å skape tomrom (se figuren nedenfor). HDP-CVD-prosessen vil bli beskrevet senere.
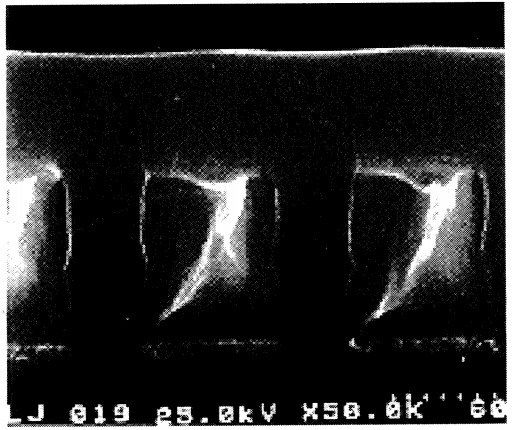
3. Plasma-etsing
Sammenlignet med våtetsing gir plasmaetsing fordeler som anisotropiske etseprofiler, automatisk endepunktdeteksjon og lavere kjemisk forbruk, sammen med rimelig høye etsehastigheter, god selektivitet og ensartethet.
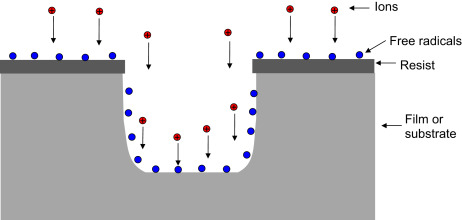
4. Kontroll av Etch-profiler
Før plasmaetsing ble utbredt i halvlederproduksjon, brukte de fleste waferfabrikker våtkjemisk etsing for mønsteroverføring. Våtetsing er imidlertid en isotrop prosess (etsing med samme hastighet i alle retninger). Når detaljstørrelser krymper under 3 µm, resulterer isotropisk etsing i underskjæring, noe som begrenser bruken av våtetsing.
I plasmaprosesser bomber ioner kontinuerlig waferoverflaten. Enten gjennom gitterskademekanismer eller sideveggspassiveringsmekanismer, kan plasmaetsing oppnå anisotropiske etseprofiler. Ved å redusere trykket under etseprosessen, kan den gjennomsnittlige frie banen for ioner økes, og dermed redusere ionekollisjoner for bedre profilkontroll.
5. Etsningshastighet og selektivitet
Ionebombardement i plasmaet hjelper til med å bryte de kjemiske bindingene til overflateatomer, og utsette dem for radikaler generert av plasmaet. Denne kombinasjonen av fysisk og kjemisk behandling øker den kjemiske reaksjonshastigheten ved etsing betydelig. Etsehastigheten og selektiviteten er diktert av prosesskravene. Siden både ionebombardement og radikaler spiller en avgjørende rolle i etsing, og RF-kraft kan kontrollere ionebombardement og radikaler, blir RF-kraft en nøkkelparameter for å kontrollere etsningshastigheten. Økning av RF-effekten kan øke etsehastigheten betydelig, noe som vil bli diskutert mer detaljert, og påvirker også selektiviteten.
6. Sluttpunktdeteksjon
Uten plasma må etseendepunktet bestemmes av tid eller visuell inspeksjon av operatøren. I plasmaprosesser, når etsingen skrider frem gjennom overflatematerialet for å begynne å etse det underliggende (endepunkt) materialet, endres den kjemiske sammensetningen av plasmaet på grunn av endringen i etsebiprodukter, tydelig gjennom en endring i emisjonsfargen. Ved å overvåke endringen i emisjonsfarge med optiske sensorer, kan etseendepunktet behandles automatisk. I IC-produksjon er dette et svært verdifullt verktøy.**




