
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Epitaksiale lag: Grunnlaget for avanserte halvlederenheter
Figur 1: Illustrerer sammenhengen mellom dopingkonsentrasjoner, lagtykkelse og nedbrytningsspenning for unipolare enheter.

Forberedelsen av SiC-epitaksiale lag omfatter først og fremst teknikker som fordampningsvekst, flytende fase-epitaksi (LPE), Molecular Beam Epitaxy (MBE) og Chemical Vapor Deposition (CVD), med CVD som den dominerende metoden for masseproduksjon i fabrikker.
Tabell 1: Gir en sammenlignende oversikt over de viktigste metodene for fremstilling av epitaksiale lag.

En banebrytende tilnærming involverer vekst på substrater utenfor aksen {0001} ved en spesifikk tiltvinkel, som vist i figur 2(b). Denne metoden øker trinntettheten betydelig samtidig som trinnstørrelsen reduseres, og letter kjernedannelse primært ved trinnsamlingssteder og dermed lar det epitaksiale laget replikere substratets stablingssekvens perfekt, og eliminerer sameksistensen av polytyper.
Figur 2: Demonstrerer den fysiske prosessen med trinnkontrollert epitaksi i 4H-SiC.
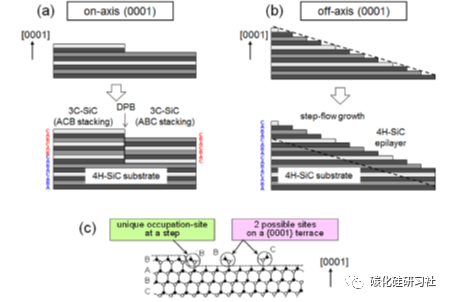
Figur 3: Viser de kritiske betingelsene for CVD-vekst i trinnkontrollert epitaksi for 4H-SiC.

Figur 4: Sammenligner veksthastigheter under forskjellige silisiumkilder for 4H-SiC-epitaksi.

I området for lav- og mellomspenningsapplikasjoner (f.eks. 1200V-enheter) har SiC-epitaksiteknologi nådd et modent stadium, og tilbyr relativt overlegen jevnhet i tykkelse, dopingkonsentrasjon og defektfordeling, og oppfyller tilstrekkelig kravene til lav- og mellomspennings-SBD , MOS, JBS-enheter og andre.
Høyspentdomenet byr imidlertid fortsatt på betydelige utfordringer. For eksempel krever enheter som er vurdert til 10 000 V epitaksiale lag med en tykkelse på omtrent 100 μm, men disse lagene viser betydelig dårligere tykkelse og dopinguniformitet sammenlignet med lavspenningsmotpartene, for ikke å nevne den skadelige innvirkningen av trekantede defekter på enhetens generelle ytelse. Høyspentapplikasjoner, som har en tendens til å favorisere bipolare enheter, stiller også strenge krav til minoritetsbærers levetid, noe som krever prosessoptimalisering for å forbedre denne parameteren.
For tiden er markedet dominert av 4-tommers og 6-tommers SiC epitaksiale wafere, med en gradvis økning i andelen av SiC epitaksiale wafere med stor diameter. Størrelsen på SiC epitaksiale wafere er fundamentalt bestemt av dimensjonene til SiC-substrater. Med 6-tommers SiC-substrater som nå er kommersielt tilgjengelige, er overgangen fra 4-tommers til 6-tommers SiC-epitaksi stadig i gang.
Etter hvert som SiC-substratproduksjonsteknologien utvikler seg og produksjonskapasiteten utvides, synker kostnadene for SiC-substrater gradvis. Gitt at substrater står for mer enn 50% av kostnadene for epitaksiale wafere, forventes de synkende substratprisene å føre til lavere kostnader for SiC-epitaksi, og dermed love en lysere fremtid for industrien.**




