
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Forstå tørretsingsteknologi i halvlederindustrien
Etsing refererer til teknikken for å selektivt fjerne materiale ved hjelp av fysiske eller kjemiske midler for å oppnå de utformede strukturelle mønstrene.
For tiden bruker mange halvlederenheter mesa-enhetsstrukturer, som hovedsakelig er skapt gjennom to typer etsning:våt- og tørrassing. Mens den enkle og raske våtetsingen spiller en betydelig rolle i fremstilling av halvlederenheter, har den iboende ulemper som isotropisk etsing og dårlig ensartethet, noe som resulterer i begrenset kontroll ved overføring av små mønstre. Tørretsing har imidlertid, med sin høye anisotropi, gode ensartethet og repeterbarhet, blitt fremtredende i produksjonsprosesser for halvlederenheter. Begrepet "tørr etsing" refererer bredt til enhver ikke-våt etsing-teknologi som brukes for å fjerne overflatematerialer og overføre mikro- og nanomønstre, inkludert laseretsing, plasmaetsing og kjemisk dampetsing. Den tørre etsingen som diskuteres i denne teksten gjelder spesifikt den snevre anvendelsen av prosesser som bruker plasmautladning – enten fysisk eller kjemisk – for å modifisere materialoverflater. Den dekker flere vanlige industrielle etseteknologier, inkludertIon Beam Etching (IBE), Reactive Ion Etching (RIE), Electron Cyclotron Resonance (ECR) plasmaetsing og Inductively Coupled Plasma (ICP) etsing.
1. Ion Beam Etching (IBE)
Også kjent som ionefresing, utviklet IBE på 1970-tallet som en rent fysisk etsemetode. Prosessen involverer ionestråler laget av inerte gasser (som Ar, Xe) som akselereres av en spenning for å bombardere målmaterialets overflate. Ionene overfører energi til overflateatomene, noe som får de med energi som overstiger bindingsenergien til å sprute bort. Denne teknikken bruker akselerert spenning for å kontrollere retningen og energien til ionestrålen, noe som resulterer i utmerket etseanisotropi og hastighetskontrollerbarhet. Selv om den er ideell for etsing av kjemisk stabile materialer som keramikk og visse metaller, kan behovet for tykkere masker for dypere etsninger kompromittere etsningspresisjonen, og høyenergi-ionebombardementet kan forårsake uunngåelig elektrisk skade på grunn av gitterforstyrrelser.

2. Reaktiv ionetsing (RIE)
Utviklet fra IBE, kombinerer RIE kjemiske reaksjoner med fysisk ionebombardement. Sammenlignet med IBE tilbyr RIE høyere etsningshastigheter og utmerket anisotropi og ensartethet over store områder, noe som gjør den til en av de mest brukte etseteknikkene innen mikro- og nanofabrikasjon. Prosessen innebærer å påføre radiofrekvensspenning (RF) til parallelle plateelektroder, noe som får elektroner i kammeret til å akselerere og ionisere reaksjonsgassene, noe som fører til en stabil plasmatilstand på den ene siden av platene. Plasmaet har et positivt potensial på grunn av at elektroner blir tiltrukket av katoden og jordet ved anoden, og skaper dermed et elektrisk felt over kammeret. Det positivt ladede plasmaet akselererer mot det katodekoblede substratet, og etser det effektivt.
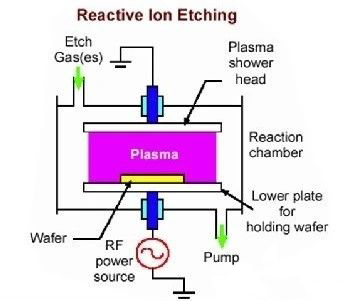
Under etseprosessen opprettholder kammeret et lavtrykksmiljø (0,1~10 Pa), noe som øker ioniseringshastigheten til reaksjonsgassene og akselererer den kjemiske reaksjonsprosessen ved substratoverflaten. Generelt krever RIE-prosessen at reaksjonsbiproduktene er flyktige for å bli effektivt fjernet av vakuumsystemet, noe som sikrer høy etsningspresisjon. RF-effektnivået bestemmer direkte plasmatettheten og akselerasjonsforspenningen, og kontrollerer derved etsningshastigheten. Men mens den øker plasmatettheten, øker RIE også forspenningen, noe som kan forårsake gitterskader og redusere selektiviteten til masken, og dermed utgjøre begrensninger for etseapplikasjoner. Med den raske utviklingen av integrerte kretser i stor skala og den avtagende størrelsen på transistorer, har det vært et større behov for presisjon og sideforhold i mikro- og nanoproduksjon, noe som fører til bruken av plasmabaserte tørretsingsteknologier med høy tetthet, noe som gir nye muligheter for utvikling av elektronisk informasjonsteknologi.
3. Elektronsyklotronresonans (ECR) plasmaetsing
ECR-teknologi, en tidlig metode for å oppnå plasma med høy tetthet, bruker mikrobølgeenergi til å resonere med elektroner i kammeret, forsterket av et eksternt påført, frekvenstilpasset magnetfelt for å indusere elektronsyklotronresonans. Denne metoden oppnår betydelig høyere plasmatettheter enn RIE, og forbedrer etsningshastigheten og maskeselektiviteten, og letter etsingen av strukturer med ultrahøyt sideforhold. Kompleksiteten til systemet, som er avhengig av koordinert funksjon av mikrobølgekilder, RF-kilder og magnetiske felt, utgjør imidlertid operasjonelle utfordringer. Fremveksten av Inductively Coupled Plasma (ICP)-etsing fulgte snart som en forenkling i forhold til ECR.
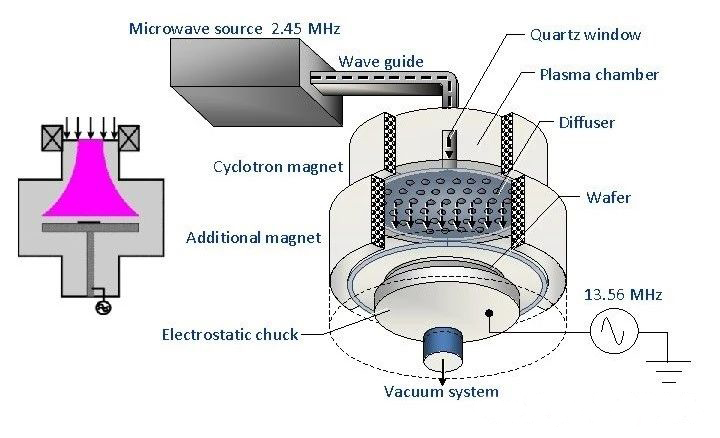
4. Induktivt koblet plasma (ICP) etsing
ICP-etsingsteknologi forenkler systemet basert på ECR-teknologi ved å bruke to 13,56MHz RF-kilder for å kontrollere både plasmagenerering og akselerasjonsforspenningen. I stedet for det eksterne magnetfeltet som brukes i ECR, induserer en spiralspole et vekslende elektromagnetisk felt, som vist i skjemaet. RF-kildene overfører energi gjennom elektromagnetisk kobling til de indre elektronene, som beveger seg i en syklotronbevegelse innenfor det induserte feltet, og kolliderer med reaksjonsgassene for å forårsake ionisering. Dette oppsettet oppnår plasmatettheter som kan sammenlignes med ECR. ICP-etsing kombinerer fordelene med ulike etsesystemer, og oppfyller behovene for høye etsehastigheter, høy selektivitet, jevnhet over store arealer og enkel, kontrollerbar utstyrsstruktur, og blir dermed raskt det foretrukne valget for en ny generasjon av plasmaetsingsteknologier med høy tetthet .
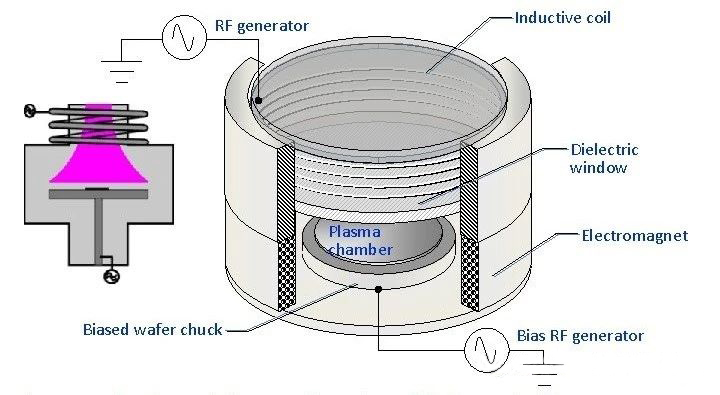
5. Kjennetegn ved tørretsing
Tørretsingsteknologi har raskt inntatt en hovedposisjon innen mikro- og nanofabrikasjon på grunn av dens overlegne anisotropi og høye etsehastigheter, og erstattet våtetsing. Kriteriene for å evaluere god tørretsingsteknologi inkluderer maskeselektivitet, anisotropi, etsehastighet, generell ensartethet og overflateglatthet fra gitterskader. Med mange evalueringskriterier må den konkrete situasjonen vurderes ut fra fabrikasjonsbehov. De mest direkte indikatorene på tørr etsing er overflatemorfologien, inkludert flatheten til det etsede gulvet og sideveggene og anisotropien til de etsede terrassene, som begge kan kontrolleres ved å justere forholdet mellom kjemiske reaksjoner og fysisk bombardement. Mikroskopisk karakterisering etter etsning utføres vanligvis ved bruk av skanningselektronmikroskopi og atomkraftmikroskopi. Maskeselektivitet, som er forholdet mellom etsningsdybden til masken og materialets under samme etsningsforhold og -tid, er avgjørende. Generelt, jo høyere selektivitet, desto bedre nøyaktighet er mønsteroverføringen. Vanlige masker som brukes i ICP-etsing inkluderer fotoresist, metaller og dielektriske filmer. Fotoresist har dårlig selektivitet og kan brytes ned under høye temperaturer eller energisk bombardement; metaller tilbyr høy selektivitet, men utgjør utfordringer i maskefjerning og krever ofte flerlags maskeringsteknikker. I tillegg kan metallmasker feste seg til sideveggene under etsing, og danne lekkasjebaner. Derfor er det spesielt viktig å velge riktig masketeknologi for etsing, og valget av maskematerialer bør bestemmes basert på de spesifikke ytelseskravene til enhetene.**




