
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Oppnå høykvalitets SiC-krystallvekst gjennom temperaturgradientkontroll i den innledende vekstfasen
Introduksjon
Silisiumkarbid (SiC) er et halvledermateriale med bred båndgap som har fått betydelig oppmerksomhet de siste årene på grunn av sin eksepsjonelle ytelse i høyspennings- og høytemperaturapplikasjoner. Den raske utviklingen av Physical Vapor Transport (PVT)-metoder har ikke bare forbedret kvaliteten på SiC-enkeltkrystaller, men har også oppnådd fabrikasjon av 150 mm SiC-enkeltkrystaller. Men kvaliteten påSiC waferekrever fortsatt ytterligere forbedring, spesielt når det gjelder å redusere defekttettheten. Det er velkjent at forskjellige defekter eksisterer i dyrkede SiC-krystaller, først og fremst på grunn av en utilstrekkelig forståelse av defektdannelsesmekanismene under SiC-krystallvekstprosessen. Ytterligere dyptgående forskning på PVT-vekstprosessen er nødvendig for å øke diameteren og lengden på SiC-krystaller, samtidig som krystalliseringshastigheten økes, og dermed akselerere kommersialiseringen av SiC-baserte enheter. For å oppnå SiC-krystallvekst av høy kvalitet, fokuserte vi på temperaturgradientkontroll under den innledende vekstfasen. Siden silisiumrike gasser (Si, Si2C) kan skade frøkrystalloverflaten under den innledende vekstfasen, etablerte vi forskjellige temperaturgradienter i det innledende stadiet og justerte til konstante C/Si-forhold temperaturforhold under hovedvekstprosessen. Denne studien utforsker systematisk de ulike egenskapene til SiC-krystaller dyrket ved bruk av modifiserte prosessforhold.
Eksperimentelle metoder
Veksten av 6-tommers 4H-SiC-boller ble utført ved bruk av PVT-metoden på 4° utenfor aksen C-flate-substrater. Forbedrede prosessforhold for den innledende vekstfasen ble foreslått. Veksttemperaturen ble satt mellom 2300-2400°C, og trykket ble holdt ved 5-20 Torr, i et miljø med nitrogen og argongass. 6-tommers4H-SiC wafereble fremstilt gjennom standard halvlederbehandlingsteknikker. DeSiC wafereble behandlet i henhold til forskjellige temperaturgradientforhold i den innledende vekstfasen og etset ved 600°C i 14 minutter for å evaluere defekter. Etsegroptettheten (EPD) av overflaten ble målt ved bruk av et optisk mikroskop (OM). Full bredde ved halv maksimum (FWHM) verdier og kartleggingsbilder av6-tommers SiC-skiverble målt ved hjelp av et høyoppløselig røntgendiffraksjonssystem (XRD).
Resultater og diskusjon

Figur 1: Skjematisk av SiC-krystallvekstmekanismen
For å oppnå høykvalitets SiC-enkrystallvekst er det vanligvis nødvendig å bruke høyrente SiC-pulverkilder, kontrollere C/Si-forholdet nøyaktig og opprettholde konstant veksttemperatur og -trykk. I tillegg er det avgjørende å minimere frøkrystalltapet og undertrykke dannelsen av overflatedefekter på frøkrystallen under den innledende vekstfasen. Figur 1 illustrerer skjemaet av SiC-krystallvekstmekanismen i denne studien. Som vist i figur 1, transporteres dampgasser (ST) til kimkrystalloverflaten, hvor de diffunderer og danner krystallen. Noen gasser som ikke er involvert i vekst (ST) desorberer fra krystalloverflaten. Når mengden gass på frøkrystalloverflaten (SG) overstiger den desorberte gassen (SD), fortsetter vekstprosessen. Derfor ble passende gass (SG)/gass (SD)-forhold under vekstprosessen studert ved å endre posisjonen til RF-varmespolen.
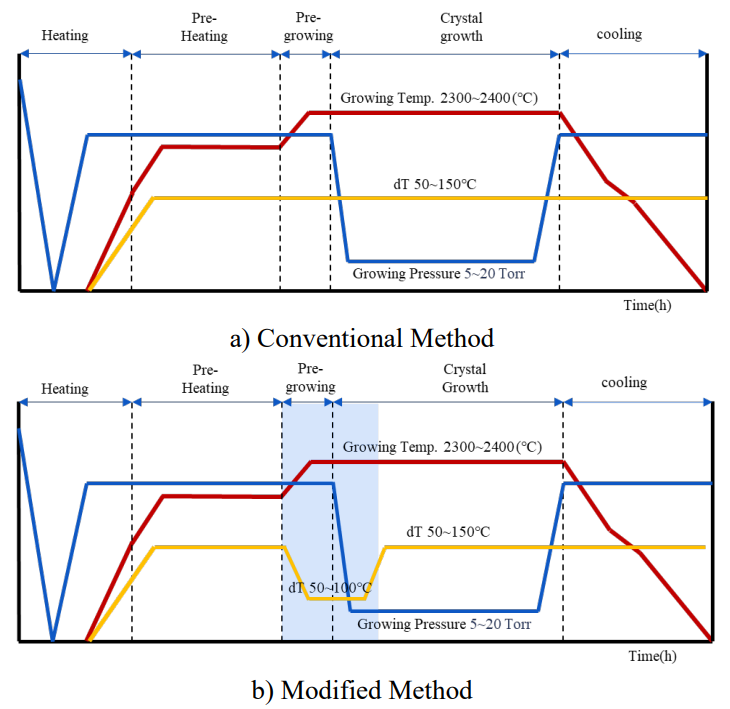
Figur 2: Skjematisk av SiC-krystallvekstprosessen
Figur 2 viser skjematisk av SiC-krystallvekstprosessen i denne studien. Den typiske vekstprosesstemperaturen varierer fra 2300 til 2400°C, med trykket holdt på 5 til 20 Torr. Under vekstprosessen holdes temperaturgradienten ved dT=50~150°C ((a) konvensjonell metode). Noen ganger kan ujevn tilførsel av kildegasser (Si2C, SiC2, Si) føre til stablingsfeil, polytype inneslutninger og dermed forringe krystallkvaliteten. Derfor, i den innledende vekstfasen, ved å endre posisjonen til RF-spolen, ble dT nøye kontrollert innenfor 50~100°C, deretter justert til dT=50~150°C under hovedvekstprosessen ((b) forbedret metode) . For å kontrollere temperaturgradienten (dT[°C] = Tbottom-Tupper), ble bunntemperaturen fastsatt til 2300°C, og topptemperaturen ble justert fra 2270°C, 2250°C, 2200°C til 2150°C. Tabell 1 viser de optiske mikroskop (OM) bildene av SiC boule-overflaten dyrket under forskjellige temperaturgradientforhold etter 10 timer.
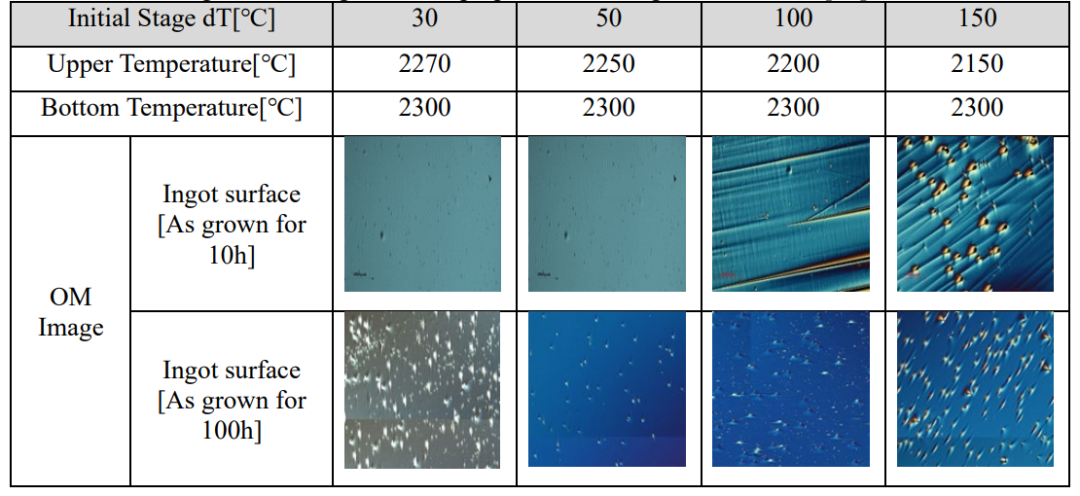
Tabell 1: Optisk mikroskop (OM)-bilder av SiC Boule-overflate dyrket i 10 timer og 100 timer under forskjellige temperaturgradientforhold
Ved en initial dT=50°C var defekttettheten på SiC boule-overflaten etter 10 timers vekst betydelig lavere enn den under dT=30°C og dT=150°C. Ved dT=30°C kan den innledende temperaturgradienten være for liten, noe som resulterer i tap av frøkrystaller og dannelse av defekter. Omvendt, ved en høyere initial temperaturgradient (dT=150°C), kan det oppstå en ustabil overmetningstilstand, noe som fører til polytype inneslutninger og defekter på grunn av høye ledige konsentrasjoner. Imidlertid, hvis den initiale temperaturgradienten er optimalisert, kan høykvalitets krystallvekst oppnås ved å minimere dannelsen av initiale defekter. Siden defekttettheten på SiC boule-overflaten etter 100 timers vekst var lik resultatene etter 10 timer, er reduksjon av defektdannelse under den innledende vekstfasen det kritiske trinnet for å oppnå SiC-krystaller av høy kvalitet.
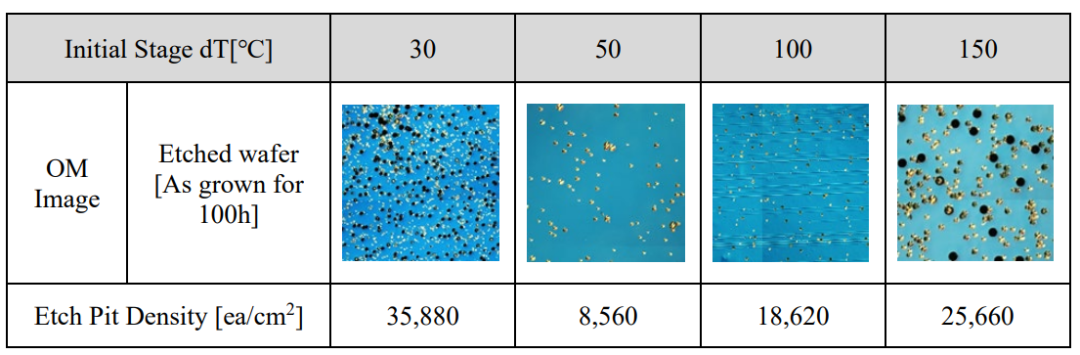
Tabell 2: EPD-verdier for etsede SiC-bouler under forskjellige temperaturgradientforhold
Waferefremstilt fra bouler dyrket i 100 timer ble etset for å studere defekttettheten til SiC-krystaller, som vist i tabell 2. EPD-verdiene for SiC-krystaller dyrket under initial dT=30°C og dT=150°C var 35.880/cm² og 25.660 henholdsvis /cm², mens EPD-verdien til SiC-krystaller dyrket under optimaliserte forhold (dT=50°C) betydelig redusert til 8560/cm².
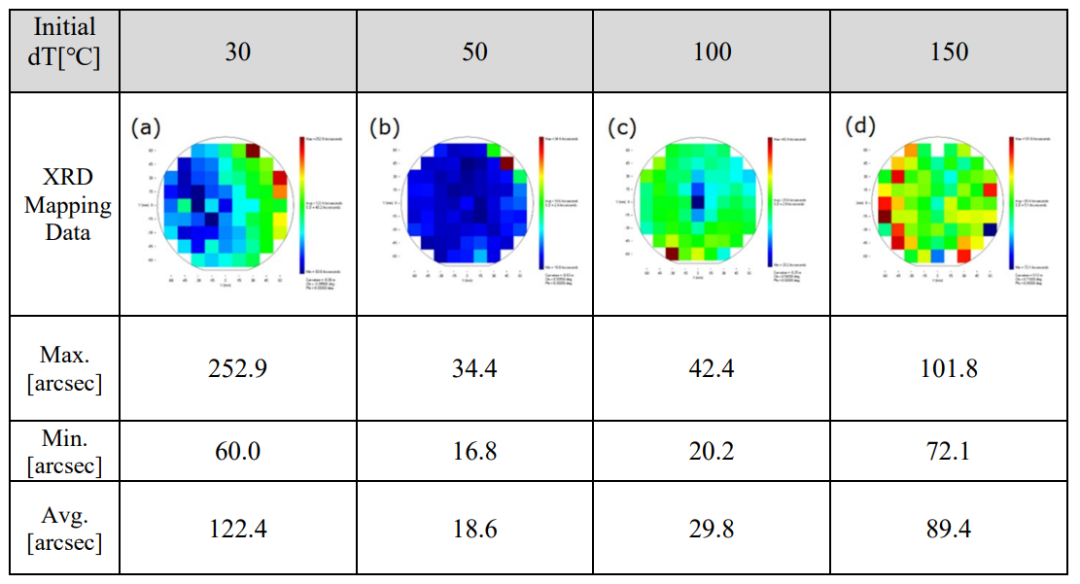
Tabell 3: FWHM-verdier og XRD-kartleggingsbilder av SiC-krystaller under forskjellige begynnelsestemperaturgradientforhold
Tabell 3 presenterer FWHM-verdiene og XRD-kartleggingsbilder av SiC-krystaller dyrket under forskjellige initiale temperaturgradientforhold. Den gjennomsnittlige FWHM-verdien til SiC-krystaller dyrket under optimaliserte forhold (dT=50°C) var 18,6 buesekunder, betydelig lavere enn for SiC-krystaller dyrket under andre temperaturgradientforhold.
Konklusjon
Effekten av temperaturgradient i innledende vekstfase på SiC-krystallkvalitet ble studert ved å kontrollere temperaturgradienten (dT[°C] = Tbottom-Tupper) ved å endre spoleposisjonen. Resultatene viste at defekttettheten på SiC boule-overflaten etter 10 timers vekst under innledende dT=50°C-forhold var betydelig lavere enn den under dT=30°C og dT=150°C. Den gjennomsnittlige FWHM-verdien til SiC-krystaller dyrket under optimaliserte forhold (dT=50°C) var 18,6 buesekunder, betydelig lavere enn for SiC-krystaller dyrket under andre forhold. Dette indikerer at optimalisering av den initiale temperaturgradienten effektivt reduserer dannelsen av initiale defekter, og oppnår dermed høykvalitets SiC-krystallvekst.**




