
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Om halvledervarmeelementer
Varmebehandling er en av de essensielle og viktige prosessene i halvlederprosessen. Termisk prosess er prosessen med å påføre termisk energi til en wafer ved å plassere den i et miljø fylt med en spesifikk gass, inkludert oksidasjon/diffusjon/gløding, etc.
Varmebehandlingsutstyr brukes hovedsakelig i oksidasjon, diffusjon, gløding og legering av fire typer prosesser.
Oksidasjoner plassert i silisiumplaten i atmosfæren av oksygen eller vanndamp og andre oksidanter for høytemperatur varmebehandling, den kjemiske reaksjonen på overflaten av skiven for å danne en oksidfilmprosess, er en av de mer utbredte i den integrerte kretsprosessen til den grunnleggende prosessen. Oksidasjonsfilm har et bredt spekter av bruksområder, kan brukes som et blokkeringslag for ioneinjeksjon og injeksjonspenetrasjonslag (skadebufferlag), overflatepassivering, isolerende portmaterialer og enhetsbeskyttelseslag, isolasjonslag, enhetsstruktur av det dielektriske laget og så videre.
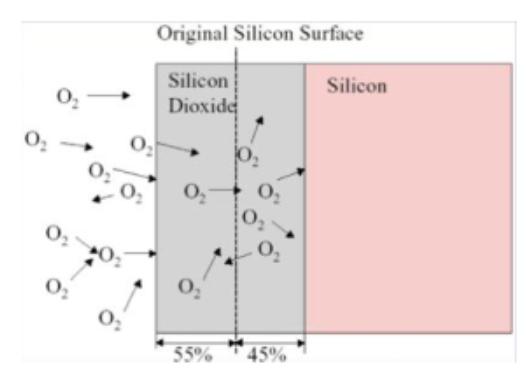
Diffusjoner i høye temperaturforhold, bruk av termisk diffusjon prinsippet av urenheter i henhold til prosessen krav dopet inn i silisium substrat, slik at det har en spesifikk konsentrasjon distribusjon, for å endre de elektriske egenskapene til materialet, dannelsen av halvleder enhet struktur. I den integrerte silisiumkretsprosessen brukes diffusjonsprosessen til å lage PN-kryss eller utgjøre integrerte kretser i motstand, kapasitans, sammenkoblingsledninger, dioder og transistorer og andre enheter.
Anneal, også kjent som termisk annealing, integrert kretsprosess, alt i nitrogen og annen inaktiv atmosfære i varmebehandlingsprosessen kan kalles annealing, dens rolle er hovedsakelig å eliminere gitterdefekter og eliminere gitterskader på silisiumstrukturen.
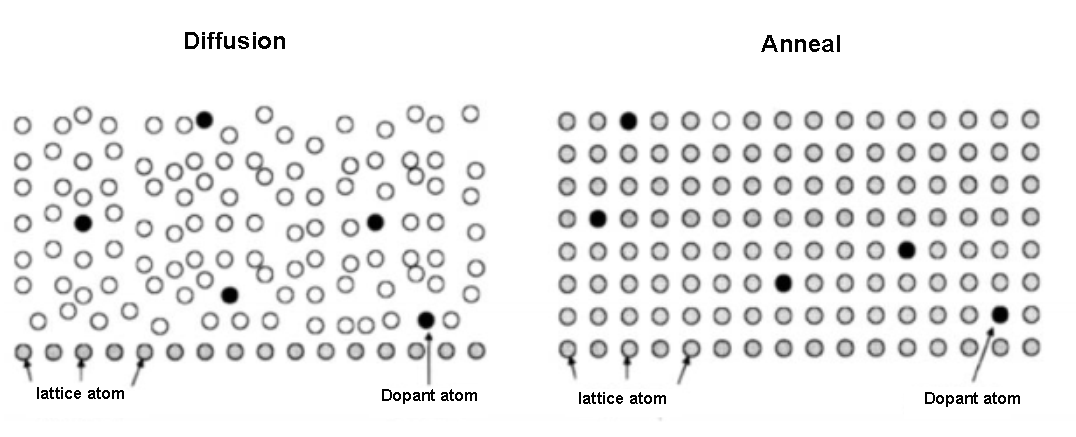
Legeringer en lavtemperatur varmebehandling som vanligvis kreves for å plassere silisiumskiver i en inertgass eller argonatmosfære for å danne en god base for metallene (Al og Cu) og silisiumsubstratet, samt for å stabilisere den krystallinske strukturen til Cu-ledningene og for å fjerne urenheter, og dermed forbedre påliteligheten til ledningene.
I henhold til utstyrsskjemaet kan varmebehandlingsutstyr deles inn i vertikal ovn, horisontal ovn og hurtig termisk prosessovn (Rapid Thermal Processing, RTP).
Vertikal ovn:Hovedkontrollsystemet til vertikal ovn er delt inn i fem deler: ovnsrør, waferoverføringssystem, gassdistribusjonssystem, eksosanlegg, kontrollsystem. Ovnrør er stedet for oppvarming av silisiumskiver, som består av vertikale kvartsbelger, flersones varmemotstandstråder og varmerørhylser. Hovedfunksjonen til waferoverføringssystemet er å laste og losse wafere i ovnsrøret. Lasting og lossing av wafere utføres av automatisk maskineri, som beveger seg mellom wafer rack-bordet, ovnsbordet, wafer-lastingsbordet og kjølebordet. Gassdistribusjonssystemet overfører riktig gassstrøm til ovnsrøret og opprettholder atmosfæren inne i ovnen. Avgangsgasssystemet er plassert i et gjennomgående hull i den ene enden av ovnsrøret og brukes til å fjerne gassen og dens biprodukter fullstendig. Kontrollsystemet (mikrokontrolleren) kontrollerer alle ovnsoperasjoner, inkludert prosesstid og temperaturkontroll, sekvens av prosesstrinn, gasstype, gassstrømningshastighet, hastighet på temperaturstigning og -fall, lasting og lossing av wafere, etc. Hver mikrokontroller har grensesnitt med en vertsdatamaskin. Sammenlignet med horisontale ovner reduserer vertikale ovner fotavtrykket og gir bedre temperaturkontroll og jevnhet.
Horisontal ovn:Kvartsrøret er plassert horisontalt for å plassere og varme opp silisiumskivene. Hovedkontrollsystemet er delt inn i 5 seksjoner som den vertikale ovnen.
Rapid Thermal Processing Furnace (RTP): Rapid Temperature Rising Furnace (RTP) er et lite, raskt oppvarmingssystem som bruker halogen infrarøde lamper som varmekilde for raskt å heve wafertemperaturen til prosesseringstemperaturen, redusere tiden som trengs for prosessstabilisering og avkjøle waferen raskt på slutten av prosessen. Sammenlignet med tradisjonelle vertikale ovner, er RTP mer avansert innen temperaturkontroll, med hovedforskjellene dens raske oppvarmingskomponenter, spesielle wafer-lastingsenheter, tvungen luftkjøling og bedre temperaturkontrollere. Den spesielle wafer-lastingsinnretningen øker gapet mellom wafere, noe som muliggjør mer jevn oppvarming eller kjøling mellom wafere. Mens konvensjonelle vertikale ovner bruker termoelementer og-RT-temperaturmålinger (P-RT) for temperaturmåling. ces bruker modulære temperaturkontroller som tillater kontroll av individuell oppvarming og avkjøling av waferne, i stedet for bare å kontrollere atmosfæren inne i ovnen. I tillegg er det en avveining mellom høye wafervolumer (150-200 wafere) og rampehastigheter, og RTP er egnet for mindre batcher (50-100 wafere) for å øke den samme størrelsen på wafere, fordi disse blir forbedret med samme størrelse, og den samme batch-størrelsen. s lokale luftstrøm i prosessen.
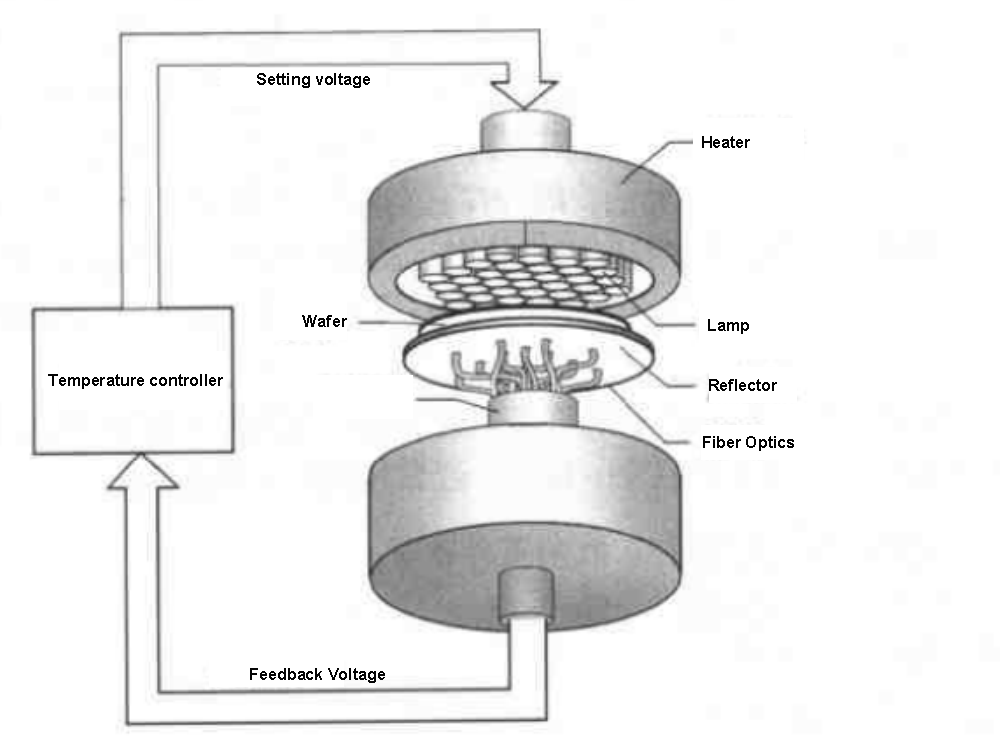
Semicorex er spesialisert påSiC-deler med CVD SiC-beleggfor halvlederprosesser, som tube, cantilever paddles, wafer båter, wafer holder, og etc. Hvis du har spørsmål eller trenger mer informasjon, vennligst kontakt oss.
Kontakt telefon #+86-13567891907
E-post:sales@semicorex.com




