
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Vanlige avbindingsmetoder
Med utviklingen av halvlederbehandling og økende etterspørsel etter elektroniske komponenter, har bruken av ultratynne skiver (tykkelse mindre enn 100 mikrometer) blitt stadig mer kritisk. Imidlertid, med pågående reduksjoner i wafertykkelse, er wafere svært sårbare for brudd under påfølgende prosesser, som sliping, etsing og metallisering.
Midlertidig binding og avbindingsteknologi brukes vanligvis for å garantere stabil ytelse og produksjonsutbytte for halvlederenheter. Den ultratynne skiven festes midlertidig på et stivt bæresubstrat, og etter behandling på baksiden separeres de to. Denne separasjonsprosessen er kjent som debonding, som primært inkluderer termisk debonding, laser debonding, kjemisk debonding og mekanisk debonding.
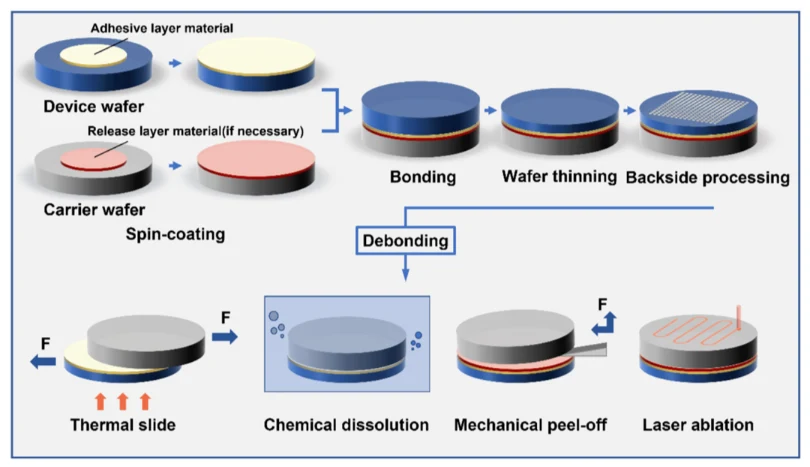
Termisk avbinding
Termisk debonding er en metode som skiller ultratynne wafere fra bærersubstrater ved å varme opp for å myke opp og dekomponere bindelimet, og dermed miste dets klebeevne. Det er hovedsakelig delt inn i termisk skliavbinding og termisk dekomponeringsavbinding.
Termisk glideavbinding involverer vanligvis oppvarming av limte wafere til deres mykningstemperatur, som varierer omtrent fra 190 °C til 220 °C. Ved denne temperaturen mister bindingslimet sin klebeevne, og ultratynne skiver kan sakte skyves eller skrelles av bærersubstrater ved hjelp av skjærkraften som påføres av enheter som f.eks.vakuum chuckerfor å oppnå en jevn separasjon. Mens i termisk dekomponering debonding, er bundne wafere varmes opp til en høyere temperatur, noe som forårsaker kjemisk dekomponering (molekylær kjede-skjæring) av limet og mister fullstendig vedheft. Som et resultat kan limte wafere løsnes naturlig uten noen mekanisk kraft.
Laseravbinding
Laseravbinding er en avbindingsmetode som benytter laserbestråling på det klebende laget av limte wafere. Det klebende laget absorberer laserenergien og genererer varme, og gjennomgår derved en fotolytisk reaksjon. Denne tilnærmingen muliggjør separering av ultratynne wafere fra bærersubstrater ved romtemperatur eller relativt lave temperaturer.
En avgjørende forutsetning for laseravbinding er imidlertid at bærersubstratet må være transparent for laserbølgelengden som brukes. På denne måten kan laserenergien med hell trenge inn i bærersubstratet og effektivt absorberes av bindingslagsmaterialet. Av denne grunn er valget av laserbølgelengde kritisk. Typiske bølgelengder inkluderer 248 nm og 365 nm, som bør tilpasses de optiske absorpsjonsegenskapene til bindematerialet.
Kjemisk frigjøring
Kjemisk debonding oppnår separasjoner av bundne wafere ved å løse opp det limende limlaget med et dedikert kjemisk løsningsmiddel. Denne prosessen krever at løsemiddelmolekyler trenger inn i klebemiddellaget for å forårsake hevelse, kjedeklipp og eventuell oppløsning, noe som gjør at ultratynne wafere og bærersubstrater kan separeres naturlig. Derfor er det ikke nødvendig med noe ekstra oppvarmingsutstyr eller mekanisk kraft levert av vakuumchucker, kjemisk frigjøring genererer minimal belastning på wafere.
I denne metoden er bæreskiver ofte forhåndsboret for å la løsemiddel komme i full kontakt og løse opp bindelaget. Limtykkelsen påvirker effektiviteten og jevnheten av løsningsmiddelpenetrering og oppløsning. Løselig lim er for det meste termoplastiske eller modifiserte polyimidbaserte materialer, vanligvis påført ved spin-coating.
Mekanisk avbinding
Mekanisk debonding skiller ultratynne wafere fra de midlertidige bærersubstratene utelukkende ved å påføre kontrollert mekanisk peeling kraft, uten varme, kjemiske løsemidler eller lasere. Prosessen ligner på å skrelle av tape, hvor waferen forsiktig "løftes" gjennom presisjonsmekanisk operasjon.
Semicorex tilbyr høy kvalitetSIC porøse keramiske debonding-chucker. Hvis du har spørsmål eller trenger ytterligere detaljer, ikke nøl med å ta kontakt med oss.
Kontakt telefonnummer +86-13567891907
E-post: sales@semicorex.com




