
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Forstå den komplette produksjonsprosessen for halvlederenheter
2024-06-17
1. Fotolitografi
Fotolitografi, ofte synonymt med mønstergenerering, er en av de mest kritiske drivkreftene bak den raske utviklingen av halvlederteknologi, som stammer fra fotografiske platefremstillingsprosesser i trykking. Denne teknikken tillater presentasjon av ethvert mønster på mikro- eller nanoskala ved hjelp av fotoresist, og når de kombineres med andre prosessteknologier, overfører disse mønstrene til materialer, og realiserer ulike design og konsepter av halvledermaterialer og -enheter. Lyskilden som brukes i fotolitografi påvirker direkte presisjonen til mønstrene, med alternativer som spenner fra ultrafiolett, dyp ultrafiolett, til røntgenstråler og elektronstråler, som hver tilsvarer økende nivåer av mønstertroskap i den nevnte rekkefølgen.
En standard fotolitografiprosessflyt inkluderer overflatepreparering, adhesjon, myk baking, eksponering, baking etter eksponering, fremkalling, hard baking og inspeksjon.
Overflatebehandling er avgjørende siden underlag vanligvis absorberer H2O-molekyler fra luften, noe som er skadelig for fotolitografi. Derfor gjennomgår underlag i utgangspunktet dehydreringsbehandling gjennom baking.
For hydrofile substrater er deres adhesjon til hydrofob fotoresist utilstrekkelig, noe som potensielt kan forårsake fotoresistløsning eller mønsterfeiljustering, og dermed behovet for en adhesjonsfremmer. For tiden er heksametyldisilazan (HMDS) og tri-metyl-silyl-dietylamin (TMSDEA) mye brukte adhesjonsforsterkere.
Etter overflatebehandling begynner påføringen av fotoresist. Tykkelsen på den påførte fotoresisten er ikke bare relatert til dens viskositet, men påvirkes også av spinnbeleggingshastigheten, vanligvis omvendt proporsjonal med kvadratroten av spinnhastigheten. Etter belegning utføres en myk baking for å fordampe løsningsmidlet fra fotoresisten, noe som forbedrer vedheft i en prosess kjent som prebake.
Når disse trinnene er fullført, skjer eksponering. Fotoresister klassifiseres som positive eller negative, med motsatte egenskaper etter eksponering.
Ta positiv fotoresist som et eksempel, der ueksponert fotoresist er uløselig i fremkaller, men blir løselig etter eksponering. Under eksponering belyser lyskilden, som passerer gjennom en mønstret maske, det belagte underlaget og mønstrer fotoresisten. Vanligvis må underlaget være på linje med masken før eksponering for å kontrollere eksponeringsposisjonen nøyaktig. Eksponeringsvarigheten må styres strengt for å forhindre mønsterforvrengning. Etter eksponering kan ytterligere baking være nødvendig for å dempe stående bølgeeffekter, selv om dette trinnet er valgfritt og kan omgås til fordel for direkte utvikling. Utvikling løser opp den eksponerte fotoresisten, og overfører maskemønsteret nøyaktig til fotoresistlaget. Utviklingstid er også kritisk - for kort fører til ufullstendig utvikling, for lang forårsaker mønsterforvrengning.
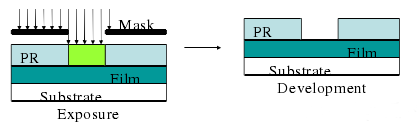
Deretter styrker hard baking festingen av fotoresistfilmen til underlaget og forbedrer dens etsemotstand. Den harde steketemperaturen er vanligvis litt høyere enn for forbakingen.
Til slutt verifiserer mikroskopisk inspeksjon om mønsteret stemmer overens med forventningene. Etter at mønsteret er overført til materialet ved andre prosesser, har fotoresisten tjent sin hensikt og må fjernes. Strippingmetoder inkluderer våt (bruker sterke organiske løsemidler som aceton) og tørr (bruker oksygenplasma for å etse bort filmen).
2. Dopingteknikker
Doping er uunnværlig i halvlederteknologi, og endrer de elektriske egenskapene til halvledermaterialer etter behov. De vanlige dopingmetodene inkluderer termisk diffusjon og ioneimplantasjon.
(1) Ioneimplantasjon
Ioneimplantasjon doper halvledersubstratet ved å bombardere det med høyenergiioner. Sammenlignet med termisk diffusjon har den mange fordeler. Ionene, valgt av en masseanalysator, sikrer høy dopingrenhet. Gjennom hele implantasjonen forblir substratet i romtemperatur eller litt over. Mange maskeringsfilmer kan brukes, for eksempel silisiumdioksid (SiO2), silisiumnitrid (Si3N4) og fotoresist, noe som gir høy fleksibilitet med selvjusterte masketeknikker. Implantatdoser er nøyaktig kontrollert, og distribusjonen av implanterte urenheter er jevn innenfor samme plan, noe som resulterer i høy repeterbarhet.
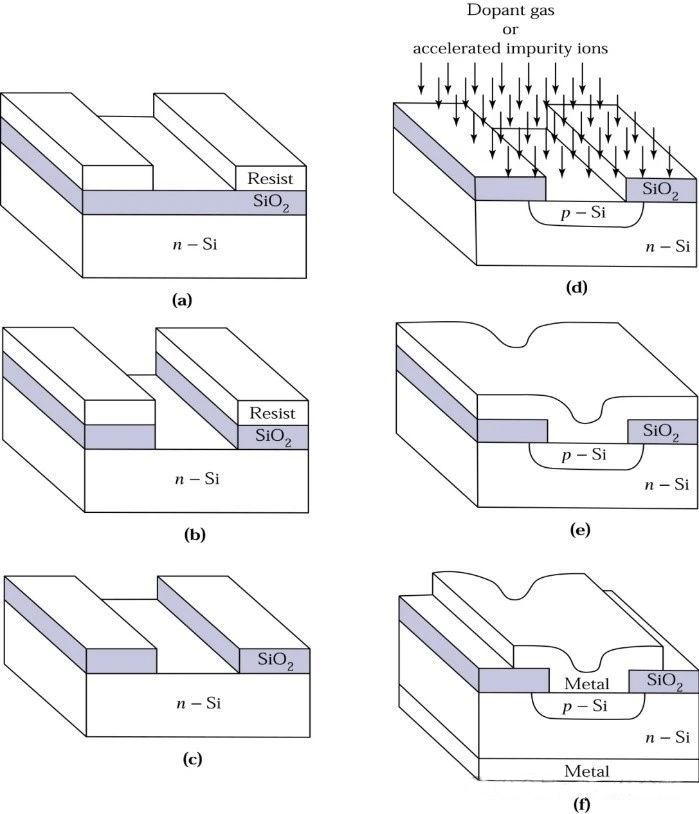
Implantasjonsdybden bestemmes av energien til ionene. Ved å regulere energien og dosen kan fordelingen av urenheter i substratet etter implantasjon manipuleres. Flere implantasjoner med varierte skjemaer kan utføres kontinuerlig for å oppnå ulike urenhetsprofiler. Spesielt i enkeltkrystallsubstrater, hvis implantasjonsretningen er parallell med den krystallografiske retningen, oppstår kanaliseringseffekter - noen ioner vil bevege seg langs kanaler, noe som gjør dybdekontroll utfordrende.
For å forhindre kanalisering utføres implantasjon typisk i en vinkel på omtrent 7° til hovedaksen til enkeltkrystallsubstratet eller ved å dekke substratet med et amorft lag.
Imidlertid kan ioneimplantasjon betydelig skade krystallstrukturen til underlaget. Høyenergi-ioner overfører ved kollisjon energi til kjerner og elektroner i substratet, noe som får dem til å forlate gitteret og danne interstitielle-ledige defektpar. I alvorlige tilfeller kan krystallstrukturen i noen regioner bli ødelagt og danne amorfe soner.
Gitterskader påvirker i stor grad halvledermaterialets elektriske egenskaper, som å redusere bærermobilitet eller levetiden til ikke-likevektsbærere. Det viktigste er at flertallet av implanterte urenheter okkuperer uregelmessige interstitielle steder, og unnlater å danne effektiv doping. Derfor er reparasjon av gitterskader etter implantasjon og elektrisk aktivering av urenheter avgjørende.
(2)Rask termisk prosessering (RTP)
Termisk gløding er den mest effektive metoden for å endre gitterskader forårsaket av ioneimplantasjon og elektrisk aktiverende urenheter. Ved høye temperaturer vil par av interstitielle ledige defekter i underlagets krystallgitter rekombinere og forsvinne; amorfe regioner vil også rekrystallisere fra grensen med enkeltkrystallområder via fastfase-epitaksi. For å hindre at substratmaterialet oksiderer ved høye temperaturer, må termisk gløding utføres i vakuum eller inert gassatmosfære. Tradisjonell gløding tar lang tid og kan forårsake betydelig omfordeling av urenheter på grunn av diffusjon.
Fremkomsten avRTP-teknologiløser dette problemet, og oppnår i stor grad reparasjon av gitterskader og aktivering av urenheter innen en forkortet utglødningsvarighet.
Avhengig av varmekilden,RTPer kategorisert i flere typer: elektronstråleskanning, pulserende elektron- og ionestråler, pulserende lasere, kontinuerlige bølgelasere og bredbånds inkoherente lyskilder (halogenlamper, grafittvarmere, buelamper), hvor sistnevnte er den mest brukte. Disse kildene kan varme opp underlaget til ønsket temperatur på et øyeblikk, fullføre gløding på kort tid og effektivt redusere urenhetsdiffusjon.
3. Filmavsetningsteknikker
(1) Plasma-Enhanced Chemical Vapor Deposition (PECVD)
PECVD er en form for kjemisk dampavsetning (CVD)-teknikk for filmavsetning, mens de to andre er atmosfærisk trykk-CVD (APCVD) og lavtrykk-CVD (LPCVD).
For tiden er PECVD den mest brukte blant de tre typene. Den bruker radiofrekvensplasma (RF) for å starte og opprettholde kjemiske reaksjoner ved relativt lave temperaturer, og letter dermed lavtemperaturfilmavsetning med høye avsetningshastigheter. Dens utstyrsskjema er som illustrert.
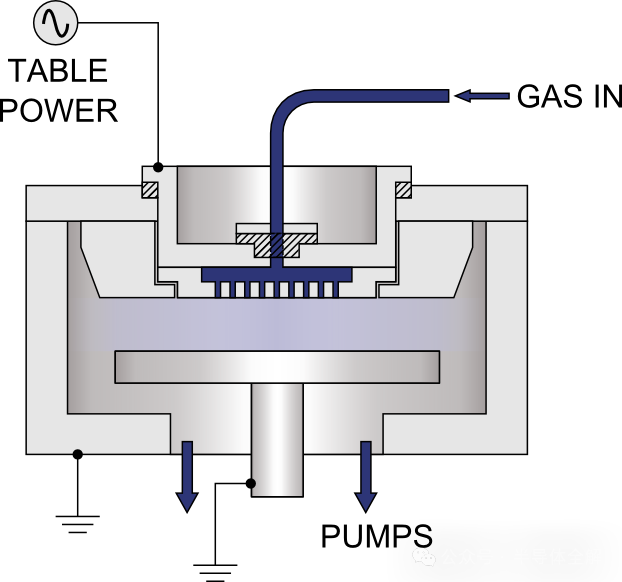
Filmer produsert med denne metoden viser eksepsjonelle vedhefts- og elektriske egenskaper, minimal mikroporøsitet, høy ensartethet og robuste småskalafyllingsevner. Faktorer som påvirker kvaliteten på PECVD-avsetning inkluderer substrattemperatur, gassstrømningshastighet, trykk, RF-effekt og frekvens.
(2) Sputtering
Sputtering er en fysisk dampavsetningsmetode (PVD). Ladede ioner (vanligvis argonioner, Ar+) akselereres i et elektrisk felt og får kinetisk energi. De er rettet mot målmaterialet, kolliderer med målmolekyler og får dem til å løsne og sprute bort. Disse molekylene har også betydelig kinetisk energi og beveger seg mot substratet og avsettes på det.

Typisk anvendte forstøvningskraftkilder inkluderer likestrøm (DC) og radiofrekvens (RF), der DC-forstøvning er direkte anvendelig på ledende materialer som metaller, mens isolasjonsmaterialer krever RF-forstøvning for filmavsetning.
Konvensjonell sputtering lider av lave avsetningshastigheter og høye arbeidstrykk, noe som resulterer i lavere filmkvalitet. Magnetronsputtering løser disse problemene mer ideelt. Den bruker et eksternt magnetfelt for å endre ionenes lineære bane til en spiralformet bane rundt magnetfeltretningen, forlenger banen deres og forbedrer kollisjonseffektiviteten med målmolekyler, og forbedrer dermed sputteringseffektiviteten. Dette resulterer i økte avsetningshastigheter, redusert arbeidstrykk og betydelig forbedret filmkvalitet.
4. Etsning Teknikker
Etsing er klassifisert i tørr og våt modus, oppkalt etter bruk (eller mangel) av spesifikke løsninger.
Etsing krever typisk klargjøring av et maskelag (som direkte kan være fotoresist) for å beskytte områder som ikke er beregnet for etsing.
(1) Tørr etsing
Vanlige tørre etsningstyper inkludererInductively Coupled Plasma (ICP) etsing, Ion Beam Etching (IBE) og Reactive Ion Etching (RIE).
Ved ICP-etsing inneholder det glødeutladningsproduserte plasmaet mange svært kjemisk aktive frie radikaler (frie atomer, molekyler eller atomgrupper), som reagerer kjemisk med målmaterialet for å danne flyktige produkter, og dermed oppnå etsing.
IBE bruker høyenergiioner (ionisert fra inerte gasser) for å direkte bombardere målmaterialets overflate for etsing, som representerer en fysisk prosess.
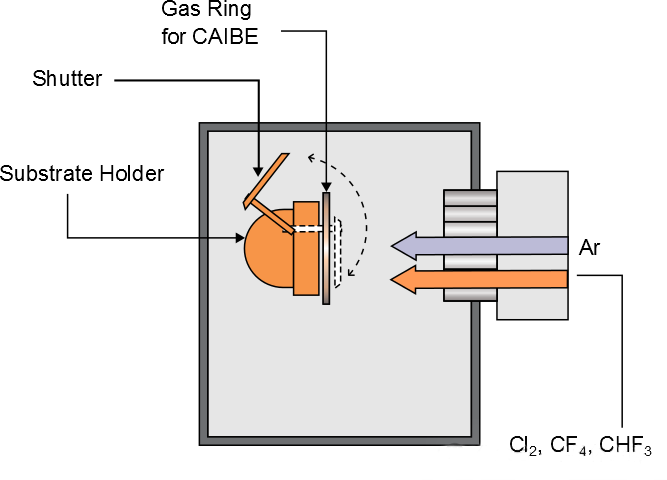
RIE regnes som en kombinasjon av de to foregående, og erstatter den inerte gassen som brukes i IBE med gassen som brukes i ICP-etsing, og utgjør dermed RIE.
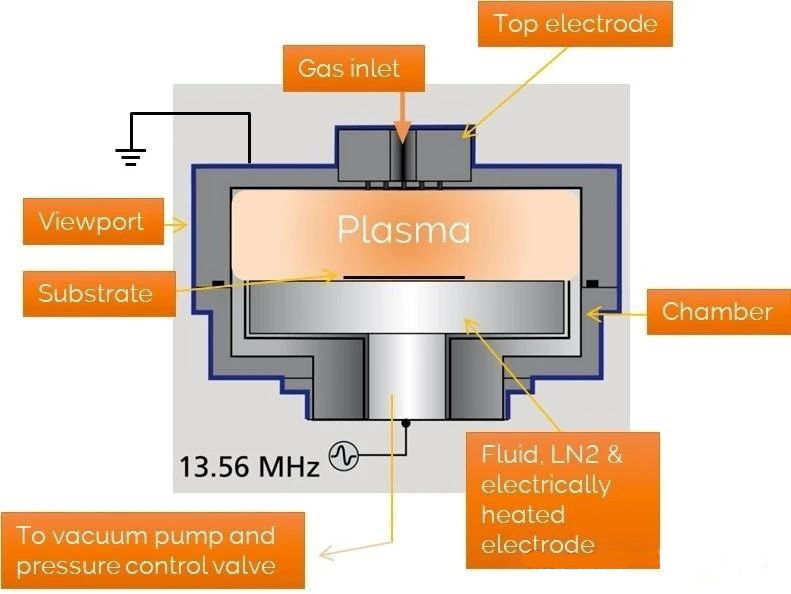
For tørretsing overskrider den vertikale etsningshastigheten langt den laterale hastigheten, dvs. den har et høyt sideforhold, som tillater presis replikering av maskemønsteret. Tørretsing etser imidlertid også maskelaget, og viser dårligere selektivitet (forholdet mellom etsehastigheter for målmateriale og maskelaget), spesielt med IBE, som kan etse ikke-selektivt over materialets overflate.
(2) Våtetsing
Våtetsing betegner metoden for etsing oppnådd ved å senke målmaterialet i en løsning (etsemiddel) som kjemisk reagerer med det.
Denne etsemetoden er enkel, kostnadseffektiv og viser god selektivitet, men har et lavt sideforhold. Materialet under maskekantene kan korroderes, noe som gjør det mindre presist enn tørretsing. For å redusere de negative virkningene av et lavt sideforhold, må passende etsehastigheter velges. Faktorer som påvirker etsehastigheten inkluderer etsemiddelkonsentrasjon, etsetid og etsemiddeltemperatur.**




