
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in Chip Manufacturing: A Professional News Report
Utviklingen av halvledermaterialer
I riket av moderne halvlederteknologi har den nådeløse drivkraften mot miniatyrisering presset grensene for tradisjonelle silisiumbaserte materialer. For å møte kravene til høy ytelse og lavt strømforbruk, har SiGe (Silicon Germanium) dukket opp som et utvalgt komposittmateriale i produksjon av halvlederbrikker på grunn av dets unike fysiske og elektriske egenskaper. Denne artikkelen fordyper seg iepitaksi prosessav SiGe og dens rolle i epitaksial vekst, anstrengt silisiumapplikasjoner og Gate-All-Around (GAA) strukturer.
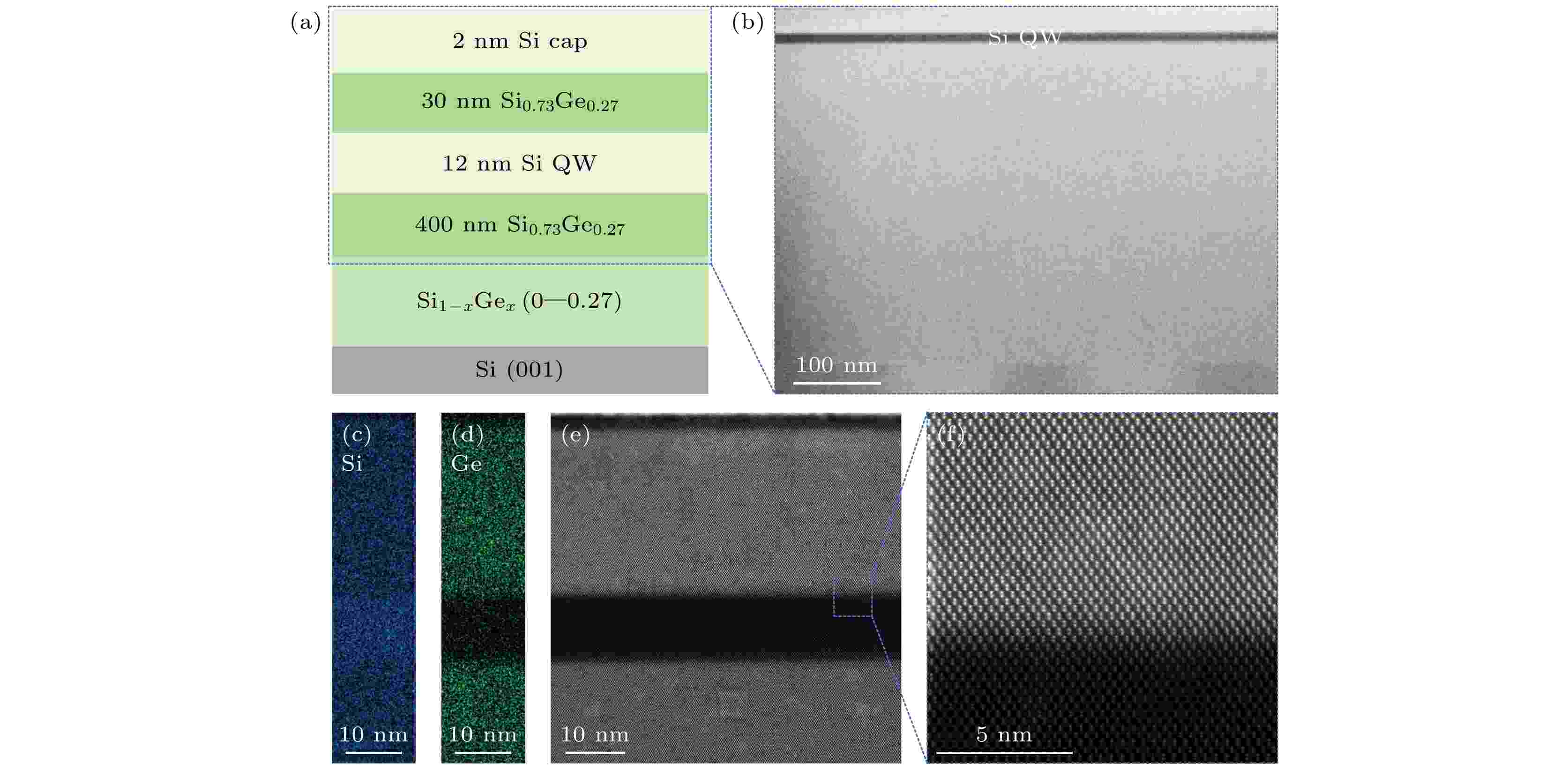
Betydningen av SiGe-epitaxi
1.1 Introduksjon til epitaksi i brikkeproduksjon:
Epitaksi, ofte forkortet som Epi, refererer til veksten av et enkeltkrystalllag på et enkeltkrystallsubstrat med samme gitterarrangement. Dette laget kan være entenhomoepitaksial (som Si/Si)eller heteroepitaksial (som SiGe/Si eller SiC/Si). Ulike metoder brukes for epitaksial vekst, inkludert Molecular Beam Epitaxy (MBE), Ultra-High Vacuum Chemical Vapor Deposition (UHV/CVD), Atmosfærisk og Reduced Pressure Epitaxy (ATM & RP Epi). Denne artikkelen fokuserer på epitaksiprosessene til silisium (Si) og silisium-germanium (SiGe) som er mye brukt i produksjon av integrerte halvlederkretser med silisium som substratmateriale.
1.2 Fordeler med SiGe Epitaxy:
Innlemme en viss andel germanium (Ge) i løpet avepitaksi prosessdanner et SiGe enkeltkrystalllag som ikke bare reduserer båndgapets bredde, men som også øker transistorens grensefrekvens (fT). Dette gjør den mye anvendelig i høyfrekvente enheter for trådløs og optisk kommunikasjon. Dessuten, i avanserte CMOS-integrerte kretsprosesser, introduserer gittermisforholdet (ca. 4%) mellom Ge og Si gitterspenning, og øker mobiliteten til elektroner eller hull og øker dermed enhetens metningsstrøm og responshastighet.
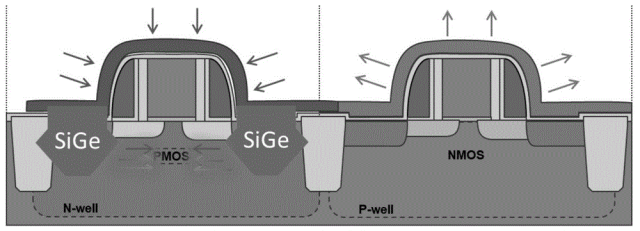
Den omfattende SiGe-epitaxy-prosessflyten
2.1 Forbehandling:
Silisiumskiver er forbehandlet basert på de ønskede prosessresultatene, primært som involverer fjerning av det naturlige oksidlaget og urenheter på waferoverflaten. For sterkt dopede substratwafere er det avgjørende å vurdere om bakforsegling er nødvendig for å redusere autodoping under påfølgendeepitaksisk vekst.
2.2 Vekstgasser og -betingelser:
Silisiumgasser: Silan (SiH4), Diklorsilan (DCS, SiH₂Cl₂) og Triklorsilan (TCS, SiHCl₃) er de tre mest brukte silisiumgasskildene. SiH₄ er egnet for lavtemperatur fullepitaksiprosesser, mens TCS, kjent for sin raske veksthastighet, er mye brukt for fremstilling av tykkesilisiumepitaksilag.
Germaniumgass: Germane (GeH₄) er den primære kilden for tilsetning av germanium, brukt i forbindelse med silisiumkilder for å danne SiGe-legeringer.
Selektiv epitaksi: Selektiv vekst oppnås ved å justere de relative hastighetene påepitaksial avsetningog in situ etsing ved bruk av klorholdig silisiumgass DCS. Selektiviteten skyldes at adsorpsjonen av Cl-atomer på silisiumoverflaten er mindre enn på oksider eller nitrider, noe som letter epitaksial vekst. SiH4, som mangler Cl-atomer og med lav aktiveringsenergi, brukes vanligvis bare på fulle epitaksi-prosesser ved lav temperatur. En annen vanlig silisiumkilde, TCS, har lavt damptrykk og er flytende ved romtemperatur, noe som krever H2-bobling for å innføre det i reaksjonskammeret. Imidlertid er det relativt billig og brukes ofte for sin raske veksthastighet (opptil 5 μm/min) for å dyrke tykkere silisiumepitaksilag, mye brukt i produksjon av silisiumepitaksi.
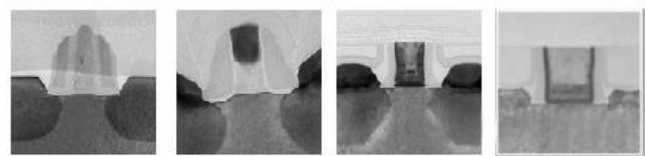
Anstrengt silisium i epitaksiale lag
I løpet avepitaksial vekst, er epitaksial enkeltkrystall Si avsatt på et avslappet SiGe-lag. På grunn av gittermisforholdet mellom Si og SiGe, blir Si-enkeltkrystalllaget utsatt for strekkspenning fra det underliggende SiGe-laget, noe som forbedrer elektronmobiliteten i NMOS-transistorer betydelig. Denne teknologien øker ikke bare metningsstrømmen (Idsat), men forbedrer også enhetens responshastighet. For PMOS-enheter dyrkes SiGe-lag epitaksialt i kilde- og dreneringsområdene etter etsing for å introdusere trykkspenning på kanalen, forbedre hullmobiliteten og øke metningsstrømmen.
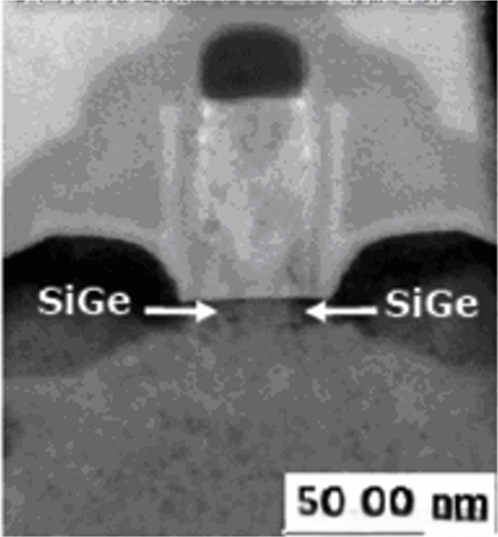
SiGe som et offerlag i GAA-strukturer
Ved produksjon av Gate-All-Around (GAA) nanotrådtransistorer fungerer SiGe-lag som offerlag. Høyselektivitets anisotropiske etsningsteknikker, for eksempel kvasi-atomisk lagetsing (quasi-ALE), tillater nøyaktig fjerning av SiGe-lag for å danne nanotråd- eller nanoarkstrukturer.
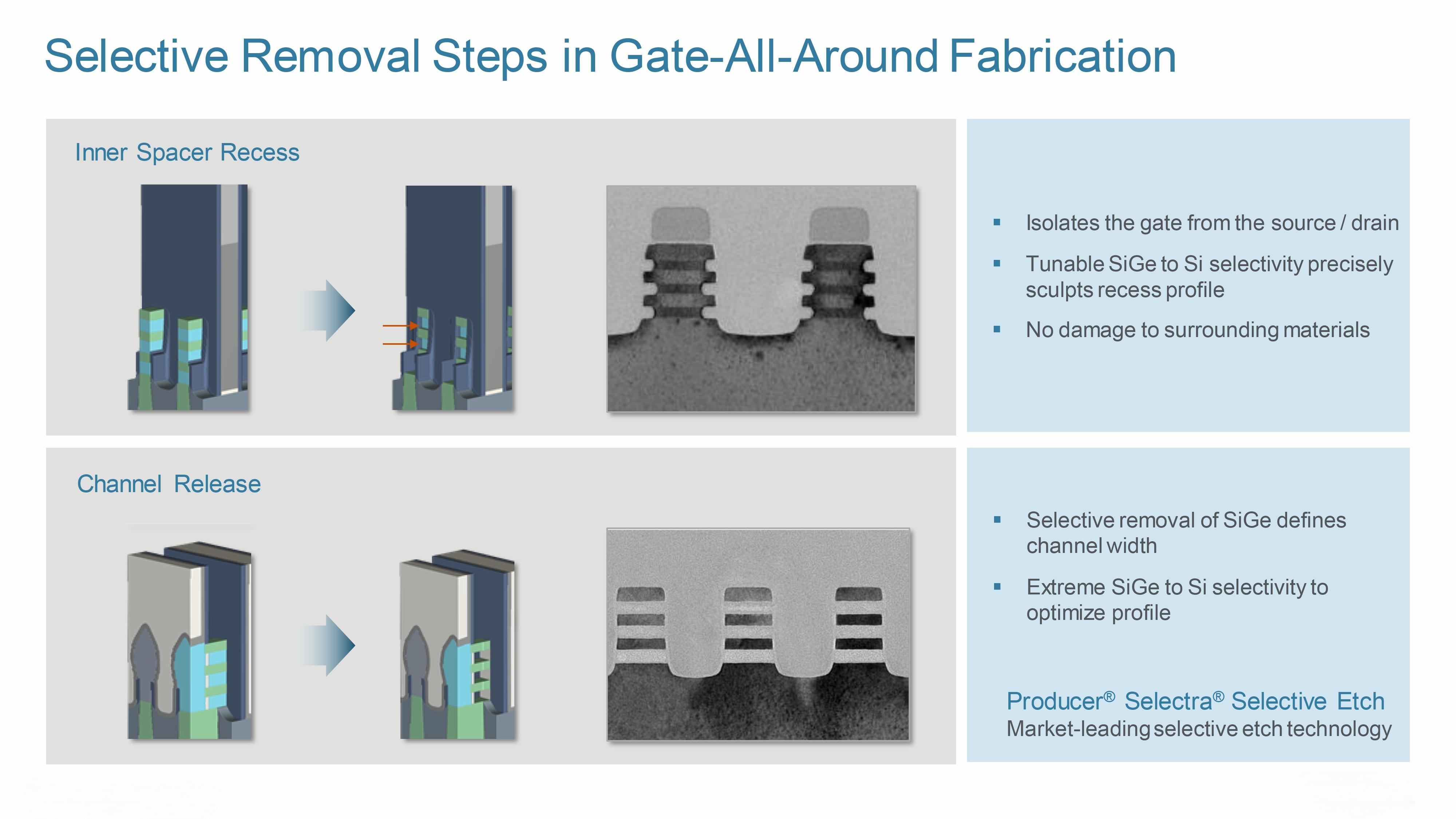
Vi i Semicorex er spesialister påSiC/TaC-belagte grafittløsningerbrukt i Si epitaksial vekst i halvlederproduksjon, hvis du har spørsmål eller trenger ytterligere detaljer, ikke nøl med å ta kontakt med oss.
Kontakttelefon: +86-13567891907
E-post: sales@semicorex.com




