
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe og Si Selective Etching Technology
Gate-All-Around FET (GAAFET), som en neste generasjons transistorarkitektur klar til å erstatte FinFET, har fått betydelig oppmerksomhet for sin evne til å gi overlegen elektrostatisk kontroll og forbedret ytelse ved mindre dimensjoner. Et kritisk trinn i fremstillingen av n-type GAAFET-er involverer høy selektivitetetsingav SiGe:Si-stabler før deponering av indre avstandsstykker, genererer silisium nanoark og frigjør kanaler.

Denne artikkelen fordyper seg i det selektiveetseteknologierinvolvert i denne prosessen og introduserer to nye etsemetoder – plasmafri etsing med høy oksidativ gass og etsing av atomlag (ALE) – som tilbyr nye løsninger for å oppnå høy presisjon og selektivitet i SiGe-etsing.
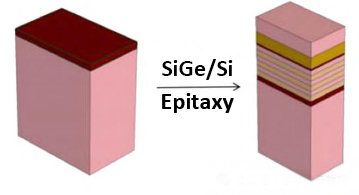
SiGe Superlattice-lag i GAA-strukturer
I utformingen av GAAFET-er, for å forbedre enhetens ytelse, er vekslende lag av Si og SiGeepitaksialt dyrket på et silisiumsubstrat, og danner en flerlagsstruktur kjent som et supergitter. Disse SiGe-lagene justerer ikke bare bærerkonsentrasjonen, men forbedrer også elektronmobilitet ved å introdusere stress. Imidlertid, i påfølgende prosesstrinn, må disse SiGe-lagene fjernes nøyaktig mens silisiumlagene beholdes, noe som krever svært selektive etseteknologier.
Metoder for selektiv etsing av SiGe
Plasmafri etsing uten høy oksidativ gass
Valg av ClF3-gass: Denne etsemetoden bruker svært oksidative gasser med ekstrem selektivitet, slik som ClF3, og oppnår et SiGe:Si-selektivitetsforhold på 1000-5000. Den kan fullføres ved romtemperatur uten å forårsake plasmaskade.
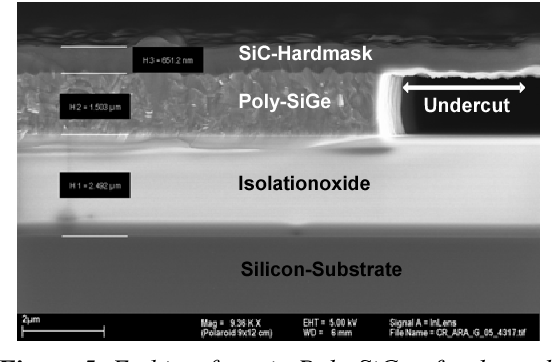
Effektivitet ved lav temperatur: Den optimale temperaturen er rundt 30 °C, noe som gir høy selektiv etsing under lave temperaturforhold, og unngår ytterligere termiske budsjettøkninger, noe som er avgjørende for å opprettholde enhetens ytelse.
Tørt miljø: Heleetseprosessutføres under helt tørre forhold, noe som eliminerer risikoen for strukturvedheft.
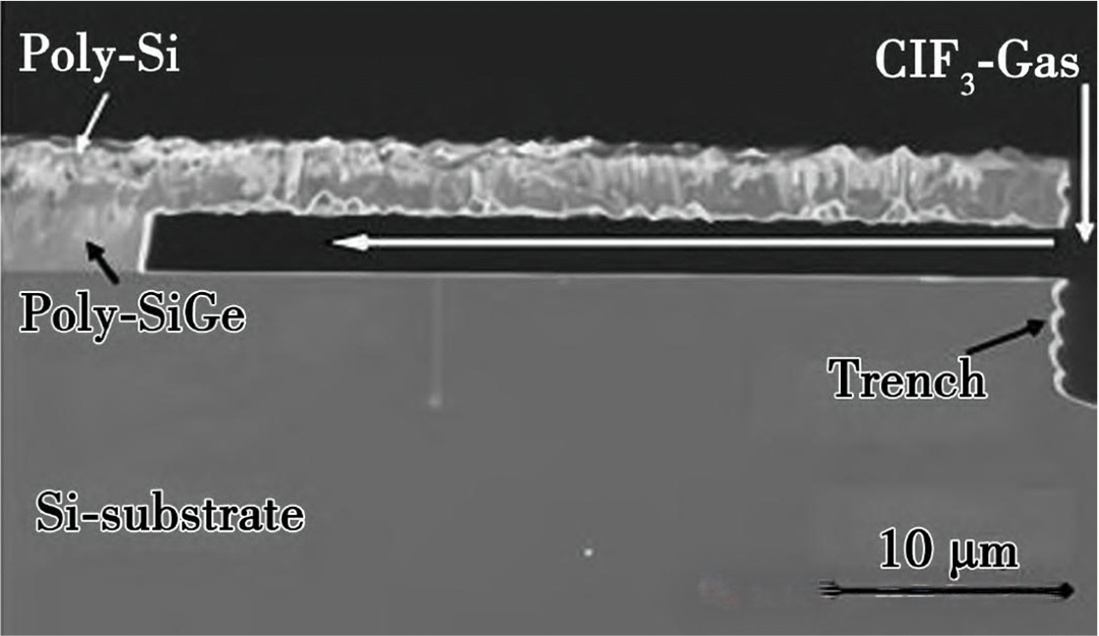
Atomic Layer Etching (ALE)
Selvbegrensende egenskaper: ALE er en to-trinns syklisketseteknologi, hvor overflaten av materialet som skal etses først modifiseres, og deretter fjernes det modifiserte laget uten å påvirke de umodifiserte delene. Hvert trinn er selvbegrensende, og sikrer presisjon til nivået for å fjerne bare noen få atomlag om gangen.
Syklisk etsing: De nevnte to trinnene sykles gjentatte ganger til ønsket etsningsdybde er oppnådd. Denne prosessen gjør det mulig for ALE å oppnåpresisjonsetsing på atomnivåi små hulrom på innerveggene.

Vi i Semicorex er spesialister påSiC/TaC-belagte grafittløsningerbrukt i etseprosesser i halvlederproduksjon, hvis du har spørsmål eller trenger ytterligere detaljer, ikke nøl med å ta kontakt med oss.
Kontakttelefon: +86-13567891907
E-post: sales@semicorex.com




